— DEV — Ultrathin-body DG MOSFET with 2-nm channel
Warning
This tutorial is under development.
Contents
- Files for the tutorial located in nextnano++\examples\transistors
DG-MOSFET-2-nm_zb_IV_2D_classical.in (Figure 2.4.519, Figure 2.4.521, Figure 2.4.524)
DG-MOSFET-2-nm_zb_IV_2D_quantum.in (Figure 2.4.519, Figure 2.4.523)
DG-MOSFET-2-nm_zb_IV_3D_classical.in (Figure 2.4.519, Figure 2.4.521, Figure 2.4.524)
- Parameters
$Temperature– temperature of the crystal and electrons$SourceDrainVoltage– bias between the source and drain$DopingConcentration– doping concentration of the source and drain
- Output files
Structure\last_region.avs.fld (Figure 2.4.519)
Structure\contact.avs.fld (Figure 2.4.519)
bias_xxxxx\density_electron.avs.fld (Figure 2.4.521, Figure 2.4.522, Figure 2.4.523 )
IV_characteristics.dat (Figure 2.4.524)
Double Gate MOSFET
This tutorial aims to simulate the I-V characteristics of a double gate metal oxide semiconductor field effect transistor (DG MOSFET). The main idea of a DG MOSFET is to control the Si channel very efficiently by choosing the Si channel width to be very small and by applying a gate contact to both sides of the channel. This concept helps to suppress short channel effects and leads to higher currents as compared with a MOSFET having only one gate.
The geometry of the simulated Double Gate MOSFET structure is shown in Figure 2.4.518. The width of the Si channel is 2 nm. The distance between the two gates is 6 nm, i.e., the isolating SiO2 is 2 nm thick on each side. The width of the two gates is 20 nm. The distance between source and drain is 60 nm. The widths and the lengths of source, drain, left, and right doped source regions are 10 nm x 10 nm each. The length of the 2 nm Si channel (without the square doped source and drain regions) is 40 nm.

Figure 2.4.518 Geometry of the simulated Double Gate MOSFET.
The material regions defined in the input file for the nextnano++ simulations are shown in Figure 2.4.519.
The blue squares (Si) are n-doped with a concentration of
A constant bias of 0.0 V and 0.2 V is applied to source and drain, respectively.
At the two gates we apply Schottky barriers of 3.443 eV, and sweep over the applied bias from

Figure 2.4.519 Schematic top view of the material regions defined in the nextnano++ simulations.
The numerical grid employed in the simulations is shown in Figure 2.4.520.

Figure 2.4.520 Grid lines of the Double Gate MOSFET
Input file
For the simulations, the following parameters, which are specified in the corresponding input file DG-MOSFET-2-nm_zb_IV_2D_classical.in, are used:
The lattice temperature is taken to be 300 Kelvin.
The classical current and nonlinear Poisson equations are solved self-consistently without including the effect of strain.
A two-dimensional simulation is performed. The overall simulation domain, that is the real space region in which the device is defined, is taken to be a rectangle having the size 22 nm x 80 nm.
Electron densities
In Figure 2.4.521 the electron density inside the MOSFET structure at

Figure 2.4.521 Electron density in units of
In Figure 2.4.522 the electron density inside the MOSFET structure at
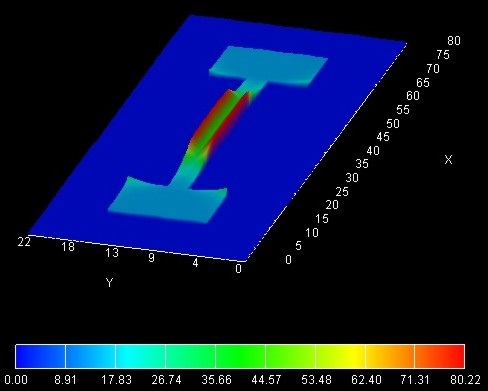
Figure 2.4.522 Electron density in units of
For comparison, Figure 2.4.523 shows the quantum mechanical electron density inside the MOSFET structure at
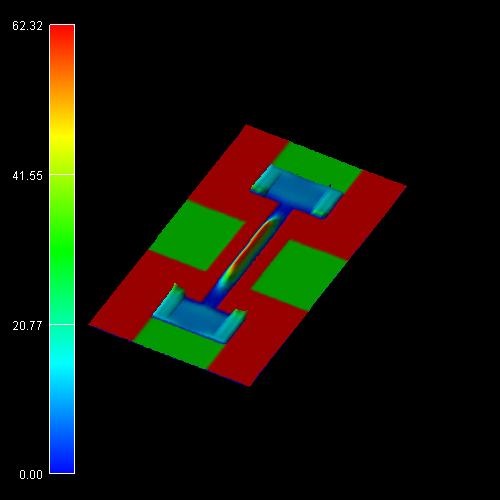
Figure 2.4.523 Quantum mechanical electron density in units of
I-V characteristics
In order to test the implementation of the three-dimensional drift-diffusion current, we performed a three-dimensional simulation of the Double Gate MOSFET. The corresponding input file is IV_DG-MOSFET_Si_3D_classical_nnp, where we assume complete ionization of the doping atoms. We further assume that the structure is homogeneous along the
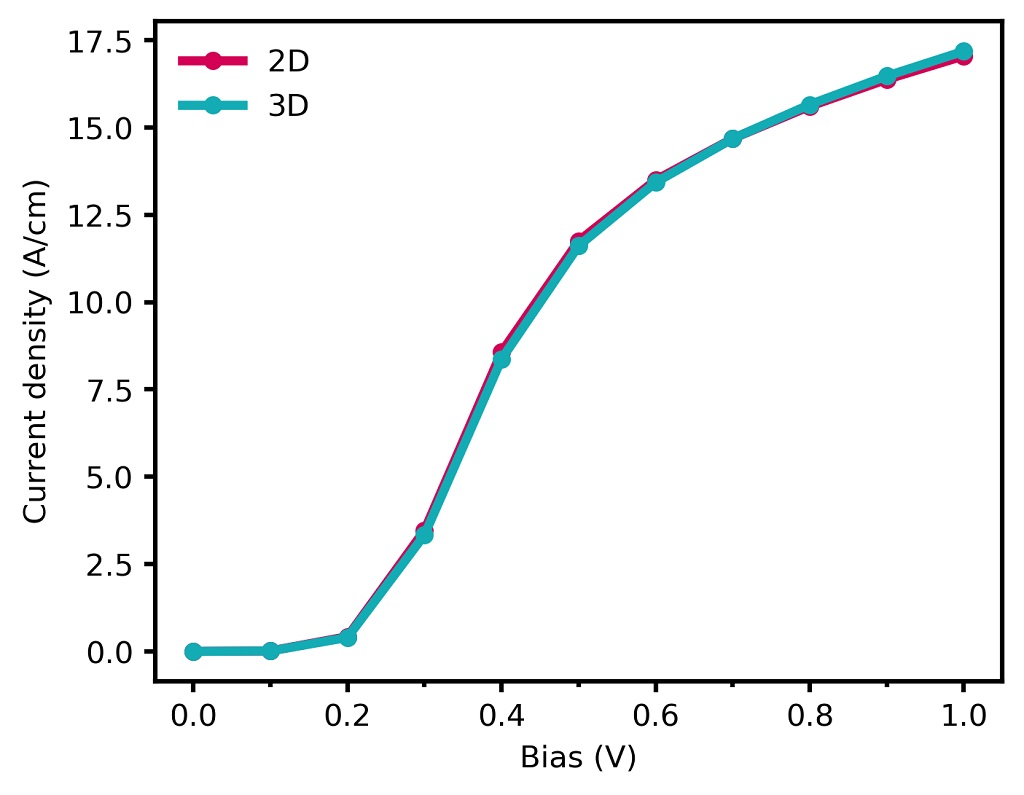
Figure 2.4.524 Comparison of the current-voltage characteristics between 2D and 3D simulations.
Last update: 21/10/2024